Контрольная работа: Анализ современных технологий изготовления гибридных микросборок
Контрольная работа: Анализ современных технологий изготовления гибридных микросборок
АНАЛИЗ СОВРЕМЕННЫХ ТЕХНОЛОГИЙ ИЗГОТОВЛЕНИЯ ГИБРИДНЫХ МИКРОСБОРОК
В настоящее время в ряде отраслей (авиакосмическом приборостроении, в телекоммуникационной
отрасли, в робототехнике) все шире используются сверхбыстродействующие
многоканальные бескорпусные микросхемы с шагом контактных площадок 50 мкм
и менее, что открывает возможность создания устройств с повышенной
функциональной емкостью. Как правило, к таким устройствам предъявляются очень
жесткие требования по массогабаритным характеристикам, объему и возможности
компоновки изделия в трех плоскостях в виде многослойных блоков и пакетов.
Проблема соответствия таким высоким требованиям была решена за счет новых
конструктивно-технологических решений на основе технологии “кристалл на гибкой
плате” или “chip on flex” (COF).
Попытка совместить
преимущества гибридных технологий с дешевизной традиционного поверхностного
монтажа (Surface Mount Tehnology – SMT) привела к созданию в середине
1980-х годов технологии “кристалл на плате” или “chip on boаrd”
(СОВ-технология). Процесс сборки изделий по СОВ-технологии подобен процессу
сборки гибридных микросхем. В СОВ-технологии в качестве основы используется
печатная плата, а бескорпусные полупроводниковые кристаллы герметизируются
заливкой (glob-top), в результате исключается корпусирование.
В настоящее время в
некоторых областях приборостроения СОВ-технология уже фактически вытеснила
поверхностный монтаж. Быстрое развитие СОВ-технологии обусловлено минимизацией
массогабаритных характеристик конечного изделия и максимизацией плотности
размещения компонентов. Занимаемая кристаллом площадь уменьшается в десятки раз
только из-за отсутствия корпуса. Дополнительным преимуществом СОВ-технологии
является тот факт, что сварные соединения, являющиеся основой сборочной
технологии “кристалл на плате” более надежны при воздействии вибрационных и
термоциклических нагрузок, чем паяные соединения, применяемые в технологии поверхностного
монтажа.
В середине 1990-х
годов была разработана еще одна технология монтажа, которая является
комбинацией традиционной технологии поверхностного монтажа (SМТ) и
СОВ-технологии. Указанная технология получила название ТАВ-технологии (Tape Automated Bonding) и предназначалась для
автоматизированного монтажа с помощью ленточных носителей микросхем с большим
количеством выводов. В этом случае выводы микросхем привариваются к медным
контактным площадкам рамок с выводами, предварительно изготовленных на медной
ленте с изолирующим покрытием. Эти выводы затем припаиваются к металлическим
проводникам на печатной плате. На ТАВ-носителях широко применяется монтаж
специализированных ИС и многокристальных модулей. Сложность ТАВ-технологии
заключается в необходимости применения специализированного автоматизированного
оборудования и в проблемах пайки выводов, расположенных с малым шагом.
В современном
приборостроении широко используются сверхбыстродействующие многоканальные
бескорпусные микросхемы с шагом контактных площадок менее 50 мкм, что позволяет
создавать устройства с повышенной функциональной емкостью. К таким устройствам
предъявляются очень жесткие требования по массогабаритным характеристикам,
объему и возможности компоновки изделия в трех плоскостях в виде многослойных
блоков и пакетов. Ни СОВ-технология, ни ТАВ-технология уже не удовлетворяют
таким высоким требованиям. Проблема была решена за счет новых
конструктивно-технологических решений на основе технологии “кристалл на гибкой
плате” или “chip on flex” (COF).
На начальном этапе
СОF-технология представляла собой ту же самую СОВ-технологию за исключением
того, что коммутирующие элементы изготавливались из гибких материалов. Сборка
электронных устройств на гибких коммутирующих элементах осуществлялась на тех
же автоматических линиях, которые используются в СОВ-технологии и с помощью тех
же самых методов монтажа кристаллов, пассивных компонентов и формирования
электрических соединений.
Гибкие кабели и платы
изготавливались на основе различных фольгированных диэлектрических материалов,
таких как майлар, лавсан, полиэтилен, полипропилен, полиэстер, полиимид и др.,
в зависимости от предъявляемых к аппаратуре требований. Гибкие коммутирующие
элементы из фольгированных диэлектриков на основе лавсана, полиэтилена и т. д.
менее дорогостоящие, но возможности монтажа компонентов на них ограничены. В
этом случае монтаж компонентов осуществляется с помощью низкотемпературной
пайки или с применением электропроводящих адгезивов. К сожалению, при обработке
таких диэлектрических материалов не удалось в полной мере применить методы
микроэлектронной технологии, основанной на принципе интегральной обработки
материалов, и полностью исключить из технологического процесса изготовления
гибких плат и кабелей механические операции формирования сквозных отверстий.
Кроме того, хотя материалы типа полиэтилена и полипропилена характеризуются
достаточно низкими диэлектрическими постоянными и, соответственно, обеспечивают
хорошие емкостные характеристики коммутирующих элементов на их основе, они не
являются радиационностойкими и не могут обеспечить высокую надежность и срок
эксплуатации электронных изделий с жесткими требованиями к радиационной
стойкости.
Только фольгированные
полиимиды оказались практически незаменимыми для создания функционально сложных
электронных изделий с высокими требованиями к радиационной стойкости,
термостойкости, быстродействию и долговременной надежности. Стабильность
электрических и размерных характеристик полиимидной основы обусловливает
высокую технологичность данного материала. Температурная стабильность и высокая
термостойкость полиимидных гибких плат позволяет применять высокотемпературные
(вплоть до 300°С) методы монтажа компонентов.
Важным фактором,
способствующим развитию СОF-технологии, послужило появление на мировом рынке
серии фольгированных медью полиимидов “Pyralux” на
основе полиимидных пленок типа Kapton, разработанных компанией DuPont
Electronic Technologies, которая является
ведущим поставщиком электронных материалов в мире. В фольгированных
диэлектриках “Pyralux LF” и “Pyralux FR” полиимидные пленки соединяются с отожженной медной
фольгой с помощью акриловых адгезивов, что позволяет изготовить целый ряд одно–
и двусторонних фольгированных диэлектриков с широким диапазоном толщин медных,
адгезивных и полиимидных слоев. Благодаря применению таких материалов в
изделиях электронной техники появилась возможность создания трехмерных
конструкций в виде двухслойных или многослойных структур малой толщины и
площади, существенно снизить их вес и объем, а также повысить их функциональную
емкость, быстродействие и надежность.
Однако применение
адгезивсодержащих фольгированных медью полиимидных пленок не позволило в полной
мере реализовать преимущества COF-технологии
при сборке микромодулей.
К недостаткам
адгезивсодержащих фольгированных полиимидов можно отнести достаточно малый
диапазон рабочих температур (–60°С ÷ +125)°С. Применение
адгезивов в фольгированных полиимидах существенно усложняет процесс
формирования сквозных отверстий в системе “металл-адгезив-полиимид” для
межслойных соединений из-за необходимости использования сложных и
трудноуправляемых процессов вскрытия “окон” в адгезивных слоях.
Эти недостатки были в
значительной степени устранены после появления гибких одно и двусторонних
безадгезивных фольгированных диэлектриков DuPont Pyralux с медной основой. Технологическое
преимущество таких материалов состоит в том, что они не содержат адгезивных
прослоек между медью и полиимидом, но обладают высокой силой сцепления между
слоем меди и поверхностью полиимида.
Материалы с безадгезивной
и высокопрочной структурой DuPont Pyralux AP и DuPont Pyralux AC являются высокотехнологичными при фотолитографической
обработке, групповом избирательном травлении сквозных отверстий в переходах и
формировании элементов топологии очень малых размеров. Наиболее важными
характеристиками этих материалов является высокая избирательность при
химобработке полиимида и меди; эластичность и механическая прочность полиимида;
высокая термостойкость (+350°С) и холодостойкость (–196°С).
Ввиду хорошей
адаптивности к фотохимическому избирательному травлению полиимида безадгезивная
структура материала позволяет полностью исключить из техпроцессов изготовления
гибких коммутирующих элементов применение механических операций сверления и
фрезерования, заменяя их групповыми процессами, и, таким образом, сократить
технологический цикл, снизить трудоемкость и, в конечном счете, уменьшить
стоимость изготовления изделий.
Кроме того, для микросхем
с высокой плотностью и прецизионностью элементов топологии при использовании
указанных материалов, оказалось
целесообразным применение методов микроэлектронной технологии, которая включает
использование жидких фоторезистов, обладающих высокой чувствительностью и
разрешающей способностью; использование практически всех способов нанесения
жидких фоторезистов (центрифугирование, погружение, пульверизация); сочетание
позитивных и негативных фоторезистов; применение стеклянных и гибких пленочных
фотошаблонов; применение установок с односторонним и двусторонним
экспонированием; применение плазмохимической и ионноплазменной избирательной
обработки материалов.
Описанные выше
достоинства безадгезивных медь-полиимидных пленочных материалов были
использованы при создании коммутирующих элементов для детекторных
микростриповых модулей в международном эксперименте STAR в BNL
(США). Возможность формирования сквозных отверстий в слоях полиимида позволила
отказаться от применения алюминиевой проволоки для соединения контактных
площадок микросхем и сенсоров с выводами коммутирующих медь-полиимидных плат и
кабелей и осуществлять присоединение выводов непосредственно к контактным
площадкам микросхем и сенсоров с помощью ультразвуковой сварки через “окна” в
полиимиде (рис. 1).
| а) |
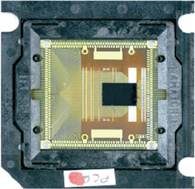
|
|
|
|
| б) |
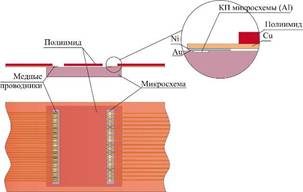
|
Рис. 1. Микросборка на медь-полиимидном
носителе:
а) – фотография (вид со стороны
микросхемы); б) – схематическое
изображение зон сварки носителя с микросхемой (вид со стороны носителя)
Вышеописанные способы
формирования межсоединений обеспечили уменьшение количества сварных соединений
в детекторных модулях практически в два раза и позволили значительно упростить
сам процесс сборки. При этом в процессе сборки полностью исключена возможность
коротких замыканий в областях сварки контактных площадок сенсоров и микросхем с
проводниками гибких кабелей и плат. Применение гибких плат специально для
микросхем позволяет не только автоматизировать процесс сборки, но и обеспечить
полный функциональный контроль микросхем, в том числе по
динамическим параметрам и, таким образом, исключить
возможность появления брака из-за микросхем при дальнейшей сборке микромодулей.
Тем не менее, и в этом
случае остались нерешенными некоторые проблемы, присущие традиционной COF-технологии на основе медь-полиимидных
фольгированных диэлектриков. По-прежнему для обеспечения надежного
безкоррозионного соединения с алюминиевыми контактными площадками микросхем и
сенсоров на медные проводники гибких плат и кабелей необходимо нанесение
дополнительных слоев никеля и золота, что усложняет процесс формирования гибких
коммутирующих элементов. С этой точки зрения наиболее оптимальным вариантом
дальнейшего совершенствования COF-технологии
является применение безадгезивных алюминий-полиимидных лакофольговых диэлектриков.
Безадгезивные алюминий -
полиимидные диэлектрики, используюмые в качестве гибких коммутирующих элементов
в COF-технологии, обладают всеми теми
достоинствами, которыми обладают и безадгезивные медь-полиимидные материалы.
Однако ряд их преимуществ по сравнению с медь-полиимидными диэлектриками
позволил существенно расширить возможности COF-технологии на современном этапе развития
приборостроения.
Прежде всего, алюминий
обладает высокой коррозионной стойкостью. Кроме того, алюминий имеет
радиационную длину почти в 6 раз
превышающую радиационную длину меди. Несмотря на то, что алюминий по сравнению
с медью обладает меньшей механической прочностью; меньшей теплопроводностью,
удельным электрическим сопротивлением примерно в 1,6 раза большим
удельного электрического сопротивления меди, важное значение имеет тот факт,
что алюминий почти в 3,5 раза легче меди. Благодаря малой плотности
алюминия обеспечивается большая электрическая проводимость на единицу массы.
Таким образом, коммутирующие элементы на основе алюминий-полиимидных
лакофольговых диэлектриков позволяют максимально минимизировать массу вещества
в рабочем объеме, что особенно перспективно для сенсорных систем с высокой
плотностью каналов информации.
Алюминиевая COF-технология хорошо адаптируется к современному
автоматизированному оборудованию ультразвуковой сварки типа Delvotec. При этом обеспечивается высокое
качество и надежность сварных соединений не только из-за того, что свариваются
однородные материалы (алюминиевые контактные площадки электронных компонентов и
алюминиевые проводники коммутирующих элементов), но также и из-за того, что
сварочные электроды, применяемые в сварочных установках, позволяют обеспечить
оптимальные режимы процессов сварки. Кроме того, коммутирующие элементы на
основе безадгезивных алюминий-полиимидных диэлектриков позволяют значительно
улучшить емкостные характеристики электронных устройств.
Специалистами Государственного
предприятия Научно-исследовательский технологический институт приборостроения (ГП НИТИП, г.
Харьков) разработана и освоена инновационная технология изготовления гибких
коммутирующих элементов на основе безадгезивных алюминий-полиимидных
лакофольговых диэлектриков и технология сборки гибридных микромодулей и
электронных узлов высокой степени интеграции.
Практическое применение
предложенная технология нашла при построении современных систем автоматического
управления летательными аппаратами различного предназначения. Гибкие кабели и
платы на основе лакофольговых диэлектриков ФДИ-А-50 и ФДИ-А-24 (полиимид толщиной
10÷20 мкм и алюминий толщиной 14÷30 мкм) характеризуются пластичностью,
гибкостью и стабильностью электрических характеристик и успешно заменяют
проволочный монтаж при сборке микромодулей.
Описанную компоновку невозможно реализовать при проволочном монтаже, так
как в этом случае объекты сварки должны иметь одностороннее расположение и
практически невозможно изменить конфигурацию проводников после сварки.
Алюминиевая COF-технология также позволяет без
ограничений располагать на одних и тех же гибких платах вместе с кристаллами
микросхем различные навесные компоненты. В этом случае, в отличие от
СОВ-технологии, SMD-компоненты
устанавливаются на платы с помощью гибких алюминий-полиимидных носителей (рис. 2, а). Сначала на гибкие носители с помощью пайки устанавливаются
SMD-компоненты (рис. 2, б), а затем гибкие носители с навесными SMD-компонентами монтируются на гибкие
платы с помощью ультразвуковой сварки. Контакты для пайки на носителях
формируются путем химического и электрохимического осаждения слоев никеля
толщиной 2 ÷ 3 мкм
и олово-висмута толщиной 7 ÷ 10 мкм. Применение таких
гибких носителей с SMD-компонентами
позволяет заменять навесные компоненты в процессе проверки функционирования
микросборок.
|

|
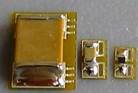
|
| а) |
б) |
Рис. 2. Монтаж SMD-компонентов по COF-технологии с помощью гибких алюминий-полиимидных
носителей:
а) – гибкие
алюминий-полиимидные носители; б) – гибкие носители с SMD-компонентами,
установленными пайкой
При этом в процессе
изготовления микросборок полностью исключается опасность загрязнения основных
плат остатками флюсов, а так же повышается технологичность слоев гибких плат и
сборочных единиц благодаря тому, что нанесение припойных покрытий (Ni-SnBi) и сборка SMD-компонентов на гибких носителях выполняются в ходе отдельных
технологических процессов.
Разработанная в ГП НИТИП инновационная
технология ультразвуковой сварки алюминий-полиимидных плат и кабелей с микросхемами
и приемниками радиационного излучения адаптирована для применения
автоматизированных сварочных установок типа FK Delvotec-6400, ЭМ-4370 и др., позволяющих
обеспечить точность позиционирования при сварке ± 3 ÷ 5 мкм.
В качестве основных
материалов в разработках использованы безадгезивные алюминий-полиимидные
лакофольговые диэлектрики типа ФДИ-А (ЫУО.037.042 ТУ) производства
ООО “Тэтраэдр” (г. Москва, Россия).
Лакофольговые
алюминий-полиимидные диэлектрики типа ФДИ-А представляют собой алюминиевую рулонную
фольгу с односторонне нанесенным полипирометиллитимидным лаковым покрытием с
последующей термической (при температуре 300°С в течение 30 мин)
имидизацией до состояния собственно полиимида. Пленочные безадгезивные
композиции были разработаны и широко применялись в СССР еще в середине
восьмидесятых годов. Они нашли широкое применение в производстве лент-носителей
ИС и БГИС с числом выводов до 500,
гибких шлейфов, многослойных плат с числом слоев до 20 и других изделий, придавая им легкость, компактность,
возможность соединения подвижных частей и формирования трехмерных схем. Однако
на тот период времени алюминий-полиимидные диэлектрики использовались только
для коммутации микросхем с шагом проводников 200 мкм и более. При участии
специалистов ГП НИТИП в разработках гибких кабелей и плат для микромодулей
международных проектов СВМ, ALICE,
удалось значительно усовершенствовать сборочную технологию “сhip on flex” и адаптировать ее к самым высоким
современным требованиям и задачам.
Список использованных источников
1. Фарассат Ф., Валев С. “Кристалл на плате”
(СОВ): новая эра сборочной технологии // Технологии в электронной
промышленности. – 2005. – № 6. – C. 71 – 76.
2. Still А. CDF Run II silicon
tracking projects // Nucl. Instr. and Meth. – 2008.- A 447.-Р. 1 – 8.
3. Merkel P. et al. CDF Run IIb Silicon Detector: Тhe Innermost Layer //
IEEE Transactions on Nuclear Science. – 2004. - Vol. 51, No 5. –
Р. 2215-2219.
4. Tricomi A. The CMS Inner Tracker Silicon Microstrip Modules:
Production and test // Nucl. Instr. аnd Meth.- 2007. - A 570. – Р. 248 – 252.
|